半導体用語集
水平ブリッジマン法(HB法)
英語表記:Horizontal Bridgman method (HB method)
水平ブリッジマン法は、融液からの水平方向一方向凝固成長法の一つである。融液からの水平方向に成長させる方法はKapitzaに由来し、炉の温度分布、温度分布の移動方法の違いによりいくつかの方法がある。基本的なHB法は図1に示すような2温度ゾーン炉に設置した舟型のボート(るつぼ)に原料融液およびその低温側の端に種子結晶を収容し、ボートを低温側に移動することにより種子結晶から徐々に結晶を成長させる方法である。水平型るつぼ移動法あるいはGeltz Hoesler法ともいう。るつぼの代わりに炉体側を移動しても同様に結晶が成長するが、その方法はアンドレーロスコー法あるいは水平型炉移動法と呼ばれる。これらの方法に対して、融液側の温度分布に種子結晶側を少し低温にした温度勾配をつけ、徐々に全体の温度を低下させて結晶を成長させる方法をHGF法あるいは元のKapitza法、水平型温度勾配付炉内徐冷法という。化合物半導体の製造に用いられる代表的な方法はHB法とHGF(Horizontal Gradient Freeze)法である。
化合物半導体の合成や結晶の成長を行う場合には揮発成分の融液からの離散を防がなければならないが、HB法やHGF法では低温部に揮発成分原料を置きその温度を制御することにより蒸気圧を制御している。この方法は垂直ブリッジマン法やCZ法と比較して装置的に非常に簡単であるので、GaAsやInPの合成、GaAsの単結晶成長に多用されている。ただし、GaAs融点でのAs平衡蒸気圧は0.9atmであるので大気圧中で合成・成長が可能であるが、InPは27気圧であるので高圧炉内で行われる(「高圧ブリッジマン法」の項参照)。以下にGaAsを例として具体的成長法を述べる。高純度(6N~7N)Ga金属およびGaAs(主に〈111〉方位)単結晶を種子結晶として石英製のボートに収容し、金属As多結晶(6N~7N)とともに、一回り大きな石英管内に真空封止する。石英とGaは反応してGa酸化物やSiOを形成するが、これらが拡散して低温部(As側)に堆積するとこの反応が進行してしまうので、これを防ぐためGaAsのHB法では高温側と低温側の境界に小穴を穿いた仕切板が設置してある。また、仕切板近傍を中温度にして拡散を制御する3T-HB法が開発されている。石英管をHB炉に設置後、高温部をGaAsの融点1,238℃以上に昇温するとともに、低温部を約600℃まで加熱してGaAsの融点における解離圧と等しいAs蒸気圧を加える。Asは仕切板を通過してGa液体に吸収され、Gaは徐々にAs溶解度が上昇し最後にGaAs融液に変化する。この間種子結晶は融点以下に保持されている。Ga側がGaAs融液になったら石英管を高温側に移動して種子結晶と融液をなじませた後、低温側に移動(1~20mm/hour)することにより結晶を成長させる。炉体を傾斜させて融液と種子結晶が触れないようにし、成長開始直前に平行に戻して融液と種子結晶を接触させる方法もHGF法では行われている。このようにして成長された結晶の形状は、底部はボート底面形状で規定され、上面は平面となり断面はDの字を横にしたような形状になる。〈111〉方位に成長した結晶から35度傾けて切り出してより円形に近い(001)面を持ったウエハが作られ、最後に超音波研削器により円形に加工される。また、適当な大きさに切断され LEC法の原料として用いられる。3T-HB法では4インチ(001)ウエハ相当の結晶まで成長されている。HB法やHGF法では結晶形状の制御が必要でない、またこのため低温度勾配下の成長により転位密度の低減が容易であるなどの利点がある。他方、成長界面がるつぼと接触するので多結晶化しやすいという問題があり、濡れに影響を与えるるつぼの表面処理(サンドブラスト)や原料の純度・不純物に注意が払われている。しかし、石英部材からのシリコンおよび酸素の結晶への混入は避けられず、高純度が要求される半絶縁性GaAs結晶は(直接合成)LEC法で成長されている。
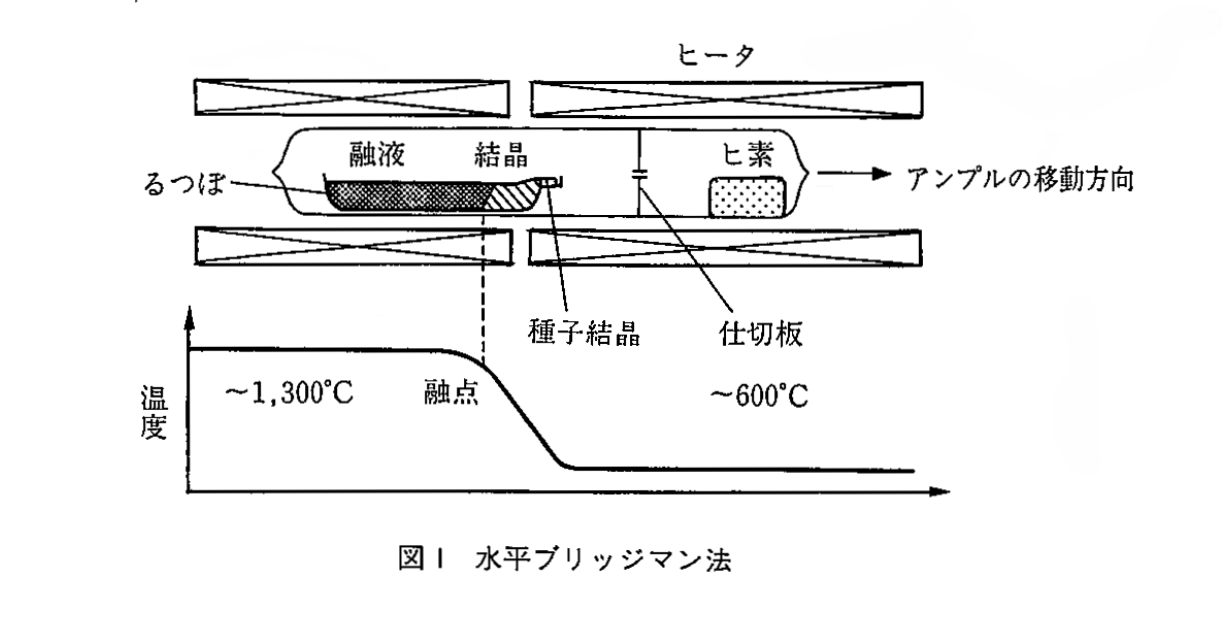
関連製品
「水平ブリッジマン法(HB法)」に関連する製品が存在しません。キーワード検索
フリーワードやカテゴリーを指定して検索できます
関連用語
関連特集
「水平ブリッジマン法(HB法)」に関連する特集が存在しません。
会員登録すると会員限定の特集コンテンツにもアクセスできます。




