半導体用語集
ELTRAN
英語表記:Epitaxial Layer Transfer
選択的エッチングを用いたBESOIの一種であり、1994年にCannonから提案された(図1)。
選択的エッチングには単結晶SiとポーラスSiのエッチング速度差を利用している。ELTRAN作製プロセスではSi基板表面をHF溶液(HF + C₂H₅OH)中で陽極酸化し、ポーラスSi層を形成する。このポーラスSi上に薄膜Si層用のSi単結晶層をエピタキシャル成長するが、エピタキシャル成長前にプリべークおよびSiH₄のプリインジェクションを行い、ポーラスSi表面の微細孔を塞ぐ。エピタキシャル層表面を熱酸化後、貼り合わせ、貼り合わせ強度を確保するための熱処理を行い、薄膜Si層側のSi基板を研削で薄くする。その後、エッチングするが、エッチング液に HF + H₂O₂ を用いると、単結晶SiとポーラスSiのエッチング速度比が 1×10⁵ と非常に大きく取れるためポーラスSiがエッチングされた後、均一な薄膜Si層(エピタキシャル層)が形成される。単結晶SiとポーラスSiのエッチング速度比が非常に大きいのは、ポーラスSiではキャピラリ効果によりエッチング液がポーラスSi層の微細孔に入り、エッチングがポーラスSi層全体で同時に進行するためである。エッチング直後の薄膜Si層表面は凹凸が大きいため1,050℃、30分の水素熱処理を行い表面を平坦化する。
ELTRANの特徴は薄膜Si層にエピタキシャル層を用いるためCOPなどのgrown-in欠陥がないことである。しかし、2×10² ~ 6×10³ cm⁻² の積層欠陥が確認されている。
また、ポーラスSi層形成時の陽極酸化条件を途中で変更し、ポーラスSi層を2層構造とし、貼り合わせ、熱処理後にポーラスSi層間で劈開させることによる生産性向上も検討されている。
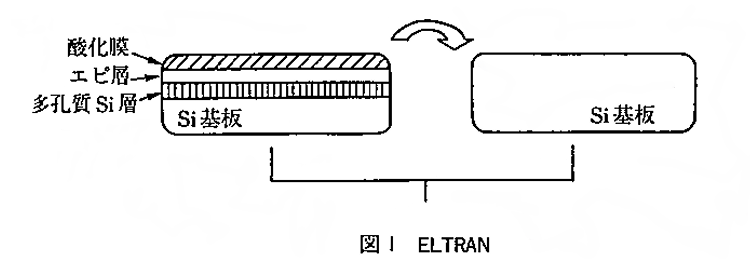
関連製品
「ELTRAN」に関連する製品が存在しません。キーワード検索
フリーワードやカテゴリーを指定して検索できます
関連用語
関連特集
「ELTRAN」に関連する特集が存在しません。
会員登録すると会員限定の特集コンテンツにもアクセスできます。




