半導体用語集
シリンダ型装置
英語表記:cylinder-type device
エピタキシャル成長装置の一種。バレル型ともいう。図1に示すように、ウェハは石英製のベルジャ内部に設置された多角錘台状のサセプタ(ウェハ保持台)にほぼ垂直保持され、ベルジャ外部に設置されたハロゲンランプにより輻射加熱される。サセプタは10rpm程度で回転しており、ウェハの均熱、ガス流均一化を図っている。原料ガスとしては厚膜成長には、主にSiCl₄、SiHCl₃、薄膜成長にはSiH₂Cl₂が用いられる。SiH₄では反応管内壁への反応生成物の堆積、いわゆるウォールデポが起こるため、本装置では使用されない。大型化により、150mm⌀で21枚、200mm⌀で10枚までウェハが載置可能となっているが、主に150mm⌀までの生産に使用されている。200mm⌀以上の大口径ウェハに対しては、枚葉エピタキシャル装置が主流になりつつある。
本装置の特徴は、スリップが発生しずらく、金属汚染・LPDなどの表面欠陥が少ないことにあり、高品質結晶を必要とする先端MOSデバイス用エピタキシャルウェハやバイポーラデバ イス用エピの製造に適している。一方、表面加熱のためウェハ裏面温度がサセプタ温度より高くなり、ウェハ裏面がエッチングされやすい。そのためにウェハ平坦度の劣化、高濃度基板での裏面からのオートドーピングによるウェハ周辺抵抗だれが生じやすいが、これらに対しては、基板裏面をCVD-SiO₂膜で被覆することで防止できる。また、先端バイポーラデバイスではサブコレクタの抵抗低減のため、n⁺埋め込み層のドーパントとしてSiへの固溶限の高いAsが用いられている。Asは常圧エピタキシャル成長ではオートドーピングが大きいため、本装置に減圧機能を設け、深さ方向、横方向のドーパント分布を制御した減圧エピタキシャル成長も実施されている。一方、本装置ではその構造上、ベルジャ内壁とウェハとの距離にウェハ面内依存性がある。そのためウェハ周辺で膜厚が厚くなる傾向があり、面内膜厚均一性を必要とするジャンクションFET、バリキャップ用エピタキシャルウェハ製造などには不向きである。
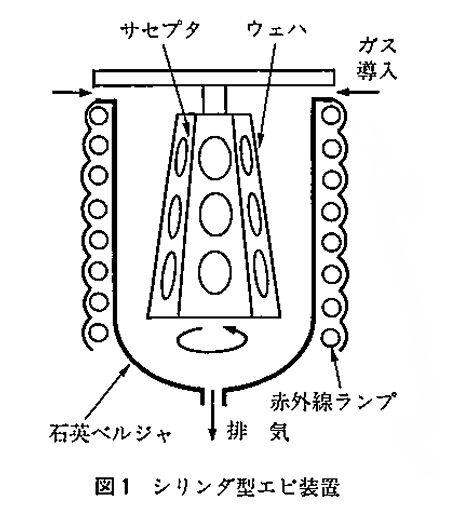
関連製品
「シリンダ型装置」に関連する製品が存在しません。キーワード検索
フリーワードやカテゴリーを指定して検索できます
関連用語
関連特集
「シリンダ型装置」に関連する用語が存在しません。
「シリンダ型装置」に関連する特集が存在しません。
会員登録すると会員限定の特集コンテンツにもアクセスできます。




