半導体用語集
マイケルソン干渉法
英語表記:Michelson interference method
マイケルソン干渉法は入射光をビームスプリッタで二つに分け、固定鏡と可動鏡で反射させた後再び合成し干渉させる方法(図1)で、その機構の単純さから2光束干渉法の主流になっている。半導体分野へはSiウェハ中の格子間酸素濃度の測定や、エピタキシャル膜厚測定を評価するFT-IRなどの評価技術として応用されている。ここではFT-IR法によるエピタキシャル膜厚の測定を例に説明する。原理は赤外干渉法と同じである。光源から出た光をマイケルソン干渉計に導入し、光をビームスプリッタで2光束に分け、一方を固定鏡(光束A)、他方(光束B)を可動鏡で反射させて、A、Bを干渉させると、光路差が波長の整数倍で強め合い、半波長ずれると弱め合う。可動鏡を一定の速度で移動させると、光束AとBの光路差が時間的に変化するため、干渉計から出る合成光の強度の時間変化は周期関数状になる。実際の光源では波長に分布があるため、その分布をF(ν)(νは波数)、AとBの光路差をxとすると、マイケルソン干渉計より出る赤外線強度Iはxの関数となり、
I(x) = ∫ F(ν) (1 + cos 2πνx ) dν …(1)
である。光路差が0の場合はAとBの位相が一致するため、強度は最大になる。光路差が0から離れると各波長の赤外光が干渉するため、強度は急速に減少する。I(x)の変調成分を示す2項目の式はインタフェログラムと呼ばれる。マイケルソン干渉計を出た光束A、Bをエピタキシャル成長膜に照射するとおのおの一部は表面、残りは基板/エピタキシャル界面で反射する。基板表面で反射された光束AとB、および界面で反射されたAとBでは光路差が0なのでマイケルソン干渉計から出た時点での位相を保持する。したがってこれらの反射光の赤外光強度のxに対する依存性は式(1)で与えられ、これら反射光強度は光路差が x = 0 で最大になる(センタバースト)。基板表面で反射された光束Aと界面で反射された光束B、またはその逆の場合はAとBに光路差があるために位相がずれ、 x = 0 では最大にならず、光路差による位相のずれを補償するxで位相が揃い、強度が増加する(サイ ドバースト)。表面反射光と界面反射光の光路差はエピタキシャル膜厚、入射角、屈折率に依存する。エピタキシャル膜厚評価では入射角を一定にすれば、屈折率は同じとみなせるため、膜厚によりサイドバーストの位置が変化することになる。逆にサイドバーストの位置が分かれば、計算により膜厚を評価できる。サイドバーストの情報はI(x)に含まれるが、これの解析にフーリエ変換を用いる。マイケルソン干渉計はフーリエ変換を組み合わせた装置はFT-IRといい、測定精度、再現性がよく、非破壊検査のため検査後のウェハをプロセス工程でそのまま使用でき、工程内で一般的に使用されている。
測定用の赤外ビームの直径は一般的に4~6mmであるが、顕微鏡と組み合わせ、より微小な領域を評価する装置も市販されている。また、ウェハ搬送の自動化、測定ポイントの多点化(ウェハ面内数 100点)と、ウェハ全面におけるマッピング表示により、エピ厚分布とデバイス特性分布との突き合わせも可能となっている。
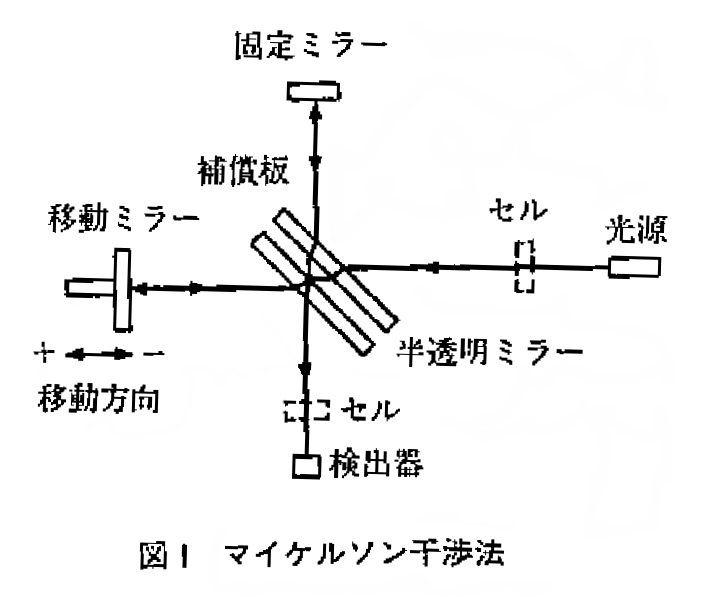
関連製品
「マイケルソン干渉法」に関連する製品が存在しません。キーワード検索
フリーワードやカテゴリーを指定して検索できます
関連用語
関連特集
「マイケルソン干渉法」に関連する特集が存在しません。
会員登録すると会員限定の特集コンテンツにもアクセスできます。




