半導体用語集
枚葉エピ装置
英語表記:single wafer reactor system
200mm⌀以上の大口径化対応用に開発・実用化されたエピタキシャル成長装置。ASM社、Applied Materials社の赤外線加熱方式と東芝機械㈱の抵抗加熱方式が市販されている。縦型、シリンダ型などバッチ型エピタキシャル成長装置との相違点は、ウェハは1枚ずつ処理する(枚葉式)、ロードロック方式、搬送を含めた自動化という点にある。枚葉式のためエピタキシャル膜均一性に優れ、面内膜厚均一性で±3%以下、面内比抵抗均一性は±5%以下とバッチ式の半分以下のばらつきである。枚葉式にも関わらず、200mm⌀で~10 枚/hr という高い生産性が達成された理由は、プロセス面では1~3 μm/min. 以上の高速成長の達成、ハード面では主にロードロック方式、自動搬送系の採用である。高速成長によりエピタキシャル成長時間は従来の~ 1/3 以下である。また、ロードロック方式の採用により反応室が大気に曝されないために、昇温中の水分によるヘイズ(くもり)発生がなく、高速昇温が可能である。かつ、自動搬送化により高温でのウェハの着脱が可能となり、1サイクルあたりの時間は、バッチ式の~ 1/10 以下に短縮されている。ロードロック方式、自動搬送化によりエピタキシャル層結晶特性も向上し、金属汚染低減によるライフタイム向上、パーティクルの低減化がなされている。
図1に示したように、赤外線加熱方式の反応炉は、回転可能なサセプタを内蔵した石英チャンバ、石英チャンバ外の上下に配置された複数赤外線ランプ、ガス導入ノズル、排気系で構成されている。ウェハはサセプタ上に設置され、赤外線ランプにより両面から加熱される。そのため面内温度均一性に優れ、~1,150℃の高温でもスリップはほとんど発生しない。反応ガスは通常SiHCI₃が使用されるが、ランプ加熱のためウォールデポが起こりやすく、数回のエピタキシャル成長に1回の割合でHCIガスエッチングが必要である。減圧成長も可能であり、この場合は原料ガスとしてSiH₂CI₂が使用される。ガス導入ノズルと排気系はガス流が層流になるように配置されており、膜厚分布制御は主に複数ある原料ガス導入ノズルの流量調整とサセプタの回転数で実施される。
抵抗加熱方式(図2)の反応炉は、円柱状の石英製であり、原料ガスは炉の上部から供給され、下部に抵抗加熱源、抵抗加熱源を取り囲む形の、高速回転可能なウェハを保持するサセプタが配置され、減圧排気系に繋がっている。特徴的な点は減圧下でサセプタを~1,000rpm以上の高速回転することで、成長速度、膜厚分布の制御性向上を達成している点である。この方式では裏面からの抵抗加熱のため、低温成長可能なSiH₄が使用できる、消費電力が少ないなどの利点がある。反面、片面加熱のためにウェハ面内温度制御に難があり、スリップが発生しやすいという欠点がある。
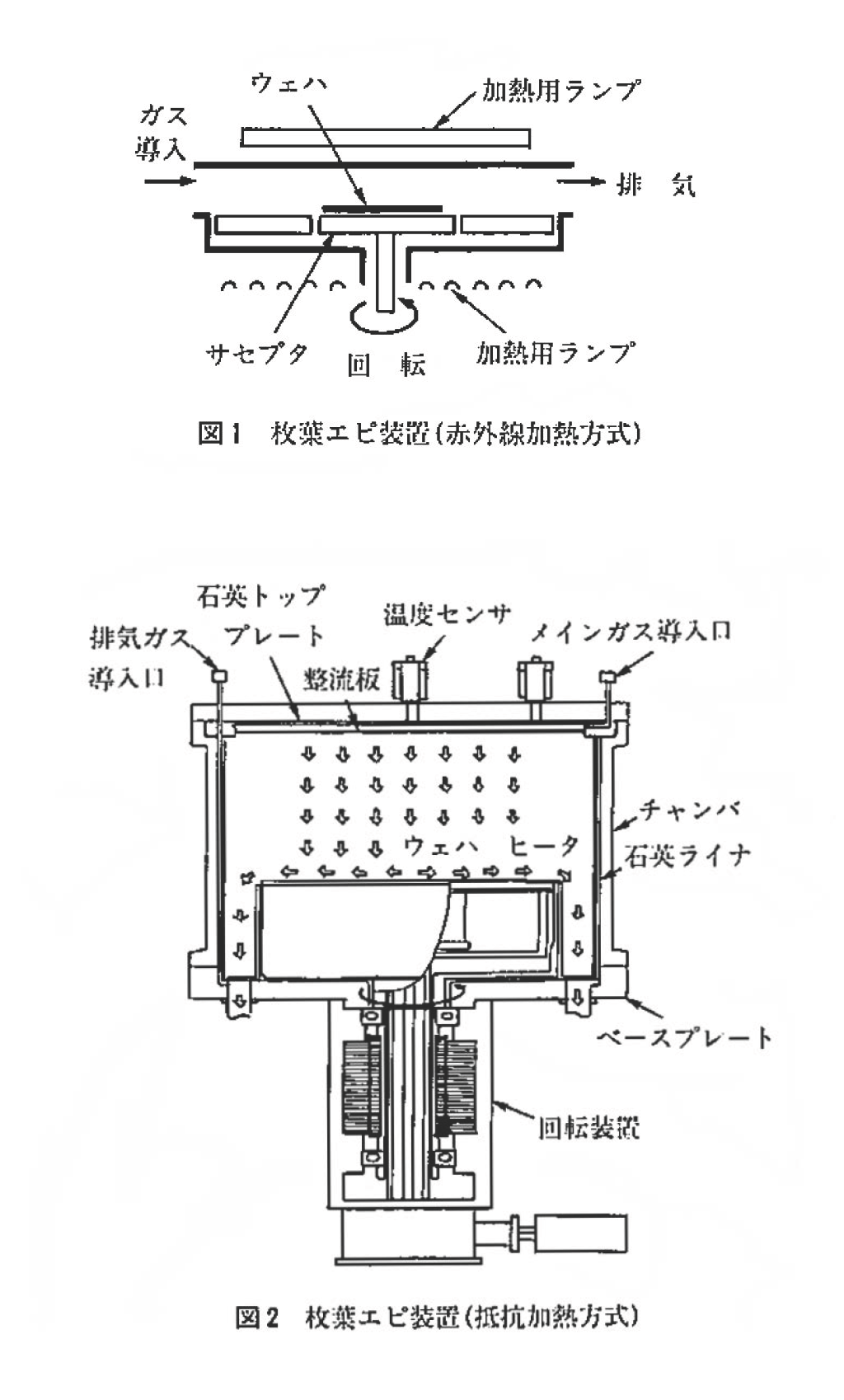
関連製品
「枚葉エピ装置」に関連する製品が存在しません。キーワード検索
フリーワードやカテゴリーを指定して検索できます
関連用語
関連特集
「枚葉エピ装置」に関連する用語が存在しません。
「枚葉エピ装置」に関連する特集が存在しません。
会員登録すると会員限定の特集コンテンツにもアクセスできます。




