半導体用語集
縦型装置
英語表記:vertical type reactor system
エピタキシャル装置の一種でディスク型、またはパンケーキ型装置ともいう。装置はガス系、反応炉、排気系、制御系より構成されている。反応炉は釣り鐘形状をした石英で、そのまま使用するタイプと、ステンレス製のアウタベルジャと石英製のインナベルジャの2重構造となっているタイプとがある。反応炉は図1に示した構造である。加熱方式は高周波誘導加熱であり、インナベルジャ内部にワークコイルと呼ばれるらせん状に巻かれた銅製角管が設置されている。ワークコイル上には、石英製のワークコイルカバーを介して、CVD-SiCコートカーボン製のディスク形状のサセプタが設置されており、ワークコイルに~35kHzの高周波を流すことでカーボン内に渦電流が誘起され、サセプタが加熱される。均熱はワークコイルとサセプタ間の距離で調整される。ガスは反応炉下部からベースプレートの中心を通って供給され、サセプタ中心からノズルで噴出する。炉形状、ノズル形状、サセプタ回転数、H₂流量などが膜厚分布など、エピタキシャル成長特性に影響を与えるが、相互に関連し合うため、経験的に最適条件を決定している。反応ガスにはSiCl₄、SiHCl₃が主に使用されるが、ウォールデポが少ないため低温成長にはSiH₄も使用されている。
本装置は、膜厚分布が良好、裏面エッチングがないため比抵抗制御性に優れる点、などがシリンダ型より優れている。また、オートドーピングが激しい高濃度Asドープ基板でもSiH₄の使用により、良好なプロファイル制御性がえられることも利点である。反面、裏面加熱のためにスリップが発生しやすい、ウェハが水平に保持されるため表面欠陥が多い、などが欠点である。特にスリップは本装置の加熱構造に起因する本質的な問題である。サセプタを通じてウェハ裏面から加熱するためウェハ表裏に温度分布が生じる。そのためウェハが凹状に沿ってウェハ周辺がサセプタから離れ、面内温度分布が生じ、スリップが発生する。この対策としてサセプタ上に“ざぐり”という窪みを設け、ウェハがそっても面内温度分布が生じにくい工夫がされているが、150mm⌀以上の大口径ウェハではスリップの発生は避けられないようである。そのため本装置はパワーMOS FET、ジャンクションFET、バリキャップなど主にディスクリート用エピタキシャルウェハの生産に使用されており、低結晶欠陥を必要とするMOS LSI用ウェハ製造にはほとんど使用されていない。
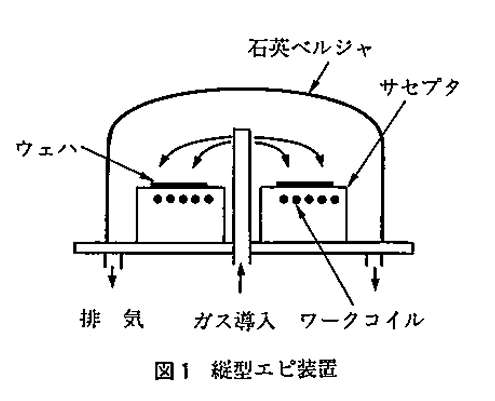
関連製品
AdvancedAce-300
Kokusai Electric株式会社
高生産性縦型装置
半導体製造装置・試験/検査装置・関連部品 › 検査装置 › ウェーハ形状計測装置
半導体製造装置・試験/検査装置・関連部品 › 検査装置 › STM/AFM
半導体製造装置・試験/検査装置・関連部品 › 検査装置 › エリプソメータ

キーワード検索
フリーワードやカテゴリーを指定して検索できます
関連用語
関連特集
会員登録すると会員限定の特集コンテンツにもアクセスできます。




