半導体用語集
リソグラフィ技術
英語表記:lithography
基板上の感光材(レジスト)に回路パターンを形成する技術をリソグラフィと呼ぶ。LSIの製造工程の中で、最も難しいキーテクノロジーの一つである。図1はリソグラフィ体系を示したものである。CADで設計されたLSIデータは、電子ビーム描画装置やレーザ描画装置を用いてレチクルマスク上に4あるいは5倍体でパターン化され、このマスクパターンを光露光装置によりシリコンウェハ上のレジストに1/4または1/5に縮小転写し、現像してレジストパターンを形成するのが、現在最もよく使われる光リソグラフィである。光リソグラフィと同様にマスクを製作してレジストパターンを形成する他の方法としては、等倍マスクを用いた等倍X線リソグラフィ、4倍体のステンシルマスクを用いたイオンビームリソグラフィ、4倍体の多層膜マスクを用いたEUVリソグラフィなどがある。これらはいずれも一括転写方式と呼ばれる。これに対して、マスクを作らずにLSIデータを用いて電子ビーム描画装置の持つパターン創生機能を使って直接ウェハ上のレジストにパターンを形成する技術が電子ビームリソグラフィである。しかしながら、電子ビーム描画装置の低スループットを解消するため、4倍体のステンシルマスクを用いてパターンを一括転写するEBステッパと呼ばれる電子ビームリソグラフィもある。
ICの誕生以来、リソグラフィとしては光が主に使われてきた。パターンの最小寸法が2μmを切った頃から、マスクパターンを5分の1に比例縮小してウェハ上に転写する縮小投影露光装置(ステッパ)が導入された。この露光方式は、高い解像度がえられるだけでなく、高精度でマスクパターン同士の位置合わせができるため、現在でも主流の方式となっている。露光に使う光の波長が短いほど解像度を上げることができるため、微細化の進展とともに、短波長化が進められてきた。当初は、波長が436nm(1nmは、10億分の1メートル)のg線と呼ばれる紫外線が用いられたが、その後、i線(波長365nm)に置き換わった。0.25μmルールからは、さらに波長の短いKrFエキシマレーザ(波長248nm)が導入され、現在、0.18μmルールの256MDRAMの量産や、0.15~0.13μmルールの1GDRAM の開発に使用されている。次の短波長化として、0.13~0.1μmの適用を目指したArFエキシマレーザリソグラフィの開発が本格的に行われている。さらに、近年、光リソグラフィの限界が叫ばれている中で、さらなる短波長化の試みが始まっている。波長157nmのF₂レーザを用いるもので(VUV : Vacuum Ultra Violetとも呼ばれている)、0.07μmルールまでの適用を目指している。
光リソグラフィは、いずれは限界がくるとみられており、X線(PXL : Proximity X-ray Lithography)、EUV ( Extreme Ultra Violet) 、電子ビーム、イオンビームなど、光に代わる新しいリソグラフィ技術の研究開発が盛んに行われている。どの方式が主流になるか、まだ見極められていない。
X線リソグラフィは、SOR (Synchrotron Orbital Radiation) 装置から放射される波長0.5~1.5nm程度のX線を利用するものであり、高い解像度がえられる。しかし、光リソグラフィと異なり、マスクパターンを等倍率で転写するため、高精度マスクの作成が難しく、20年以上開発が続けられているが実用化には至っていない。
EUVリソグラフィは、波長13nmの軟X線を用いて縮小投影露光を行うものである。この波長領域では、多層膜を利用した反射ミラーで光学系を構成しなければならない。マスクも多層膜基板上に作る必要がある。解決すべき課題は多いが、21世紀での実用化が期待されている。
電子ビームリソグラフィには、電子ビームのパターン創生機能を生かした直接描画方式とマスクを用いて一括転写を行う方式とがある。直接描画方式は、マスクを用いずにウェハ上に直接、パターンを描く方法であり、0.1μm以下の解像度が得られるが、描画に時間がかかり生産性が低い。このため、LSIパターンには繰り返しが多いことに着目して、繰り返しの基本パターンをアパーチャに作りこんで描画時間を短縮する方式(部分一括転写方式)も実用化された。しかし、用途は少量生産やデバイスの研究開発用に限られている。一方、一括転写方式は、光リソグラフィと同程度の処理能力が期待できるので近年注目を集めているが、他の方式と同じように高精度マスクの実現が実用化の鍵と見なされている。
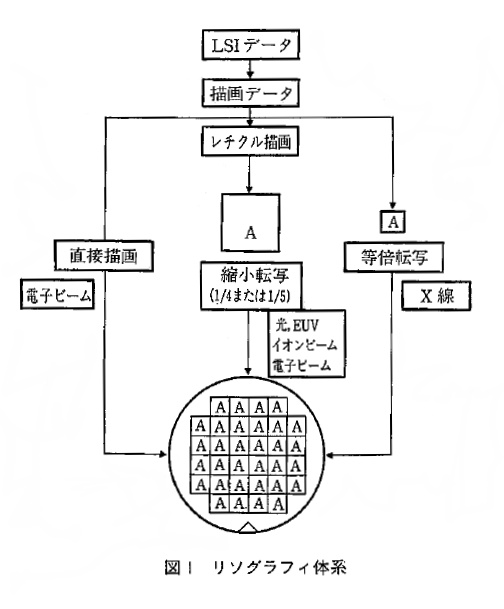
関連製品
「リソグラフィ技術」に関連する製品が存在しません。キーワード検索
フリーワードやカテゴリーを指定して検索できます
関連用語
関連特集
会員登録すると会員限定の特集コンテンツにもアクセスできます。




